二氧化硅(SiO₂)是由硅和氧原子通过共价键形成的无机化合物,是半导体工艺中应用最广泛、最基础的绝缘材料。
SiO₂的合成方法:ALD、LPCVD与SOD
芯片制造中,SiO₂薄膜的制备依赖多种工艺,不同方法的特点与原料如下:
| | | |
|---|
| | - 氧源:O₃、H₂O等离子体反应:SiCl₄ + 2H₂O → SiO₂ + 4HCl↑ | 厚度控制精度高(±0.1 nm),适合复杂三维结构(如FinFET侧墙) |
| 硅烷(SiH₄)与氧气(O₂)在高温下反应生成SiO₂ | 反应:SiH₄ + 2O₂ → SiO₂ + 2H₂O↑ 温度:400-600℃ 压力:0.1-1 Torr | 沉积速率快(50-100 nm/min),成本低,适合大面积沉积(如STI填充) |
| | | |
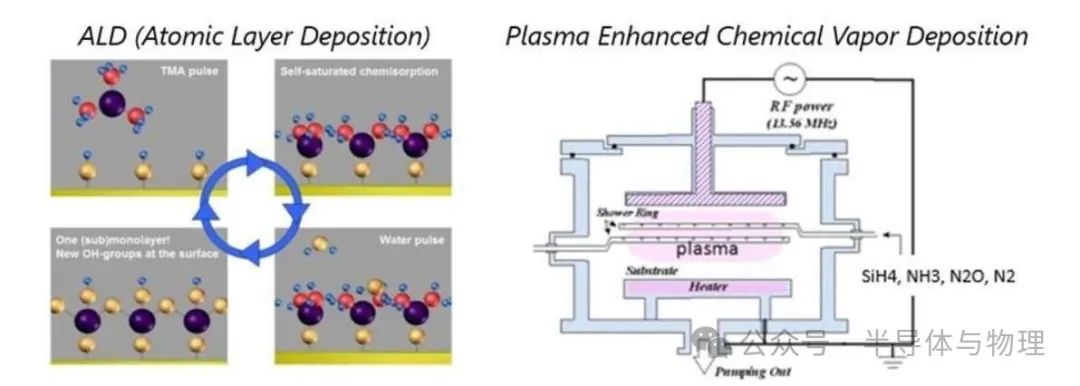
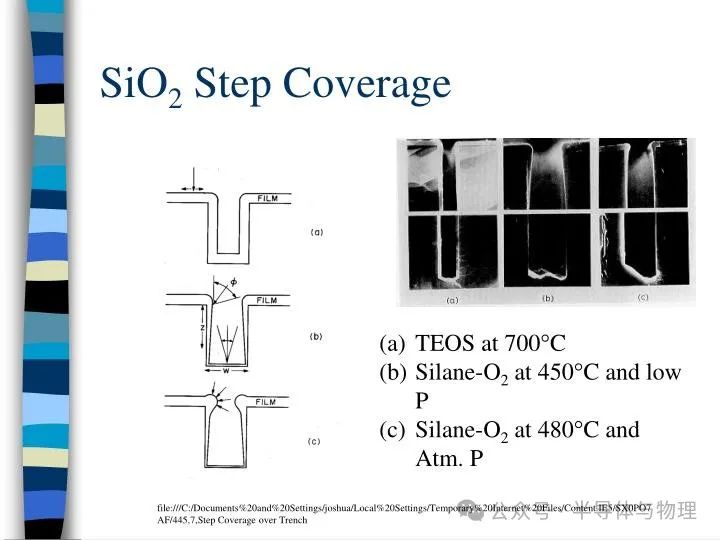

SiO₂在芯片制造中的核心作用
1. 栅极氧化绝缘材料
在传统MOSFET中,SiO₂直接作为栅介质隔离栅极与沟道。例如,90 nm制程中,SiO₂厚度≈1.2 nm。厚度<2 nm时,量子隧穿效应导致漏电流剧增。现代工艺中,SiO₂作为High-K材料(如HfO₂)的界面层(0.5-1 nm),优化界面态密度。2. 栅极侧墙调控离子注入
LDD(轻掺杂漏极)与Halo注入
- 沉积SiO₂侧墙→作为掩膜阻挡离子注入,形成浅结(LDD)和抑制短沟道效应(Halo)。侧墙宽度(10-30 nm)决定注入区域尺寸。例如,侧墙越宽,LDD结深越浅,提升抗短沟道能力。
3. 浅沟槽隔离(STI)
刻蚀硅衬底形成沟槽→SOD填充SiO₂→化学机械抛光(CMP)平坦化。隔离相邻晶体管,防止漏电。例如,7 nm制程中,STI宽度<20 nm,需优化SiO₂填充致密性。4. 掩膜层(如SAQP掩膜)
自对准四重图案化(SAQP)旨在通过多次图形转移,在不增加光刻复杂度的情况下,将初始图案细分为四个更精细的图案,以实现更高分辨率。首先利用标准光刻创建初步图案,然后通过沉积和刻蚀一系列间隔层细分图案,每次仅在前一步骤的线条侧壁留下间隔物。重复此过程两次以上,逐步细化图案至目标尺寸,最后将精细图案转移到实际器件层上,如多晶硅栅极或金属互连层。这一技术对于10纳米及以下节点至关重要。5. 绝缘隔离作用
层间介质(ILD):在金属互连层间沉积SiO₂(或掺氟SiO₂,k≈3.5),减少线路间电容耦合。